Chemical Precursors
In North America and Europe, and through our subsidiaries of TSMD Taiwan and TSMD Korea, Tosoh SMD is the sales representative for chemical precursor and OLED materials developed by Tosoh Corporation for advanced semiconductor and display applications. Tosoh Corporation has developed chemical Precursors to provide important process, film, and cost of ownership advantages.


One such material developed by Tosoh Corporation and now being evaluated by customers is Ru precursor, DER. The structure of DER is unique which provides properties that are advantageous compared to competitor’s Ru precursors.
The DER structure provides short incubation time for deposition and a lower effective deposition temperature. Dense film nucleation, smooth film morphology, and excellent step coverage are achieved using the DER. Contact us for additional information.
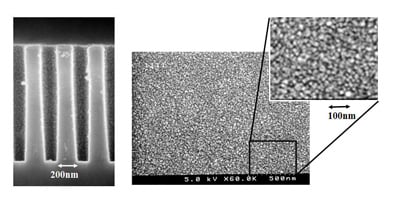
Process |
Element |
Precursor |
Characteristics |
|||
MOCVD |
Metal |
Ru |
RuDER® |
Melting point |
: 17°C |
|
Vapor pressure |
: 0.1Torr (@75°C) |
|||||
Decomp. Temp. |
: 270°C |
|||||
Viscosity |
: 7cp (@25°C) |
|||||
Rudense® |
Melting point |
: 28°C |
|
|||
Vapor pressure |
: 0.1Torr (@76°C) |
|||||
Decomp. Temp. |
: 230°C |
|||||
Viscosity |
: 15cp (@65°C) |
|||||
Ir |
Ts-Ir5 |
Melting point |
: 15°C |
|
||
Vapor pressure |
: 0.1Torr (@75°C) |
|||||
Decomp. Temp. |
: 300°C |
|||||
Viscosity |
: 35cP (@25°C) |
|||||
Co |
Ts-Co10 |
Melting point |
: < -20°C |
|
||
Vapor pressure |
: 0.1Torr (@88°C) |
|||||
Decomp. Temp. |
: 214°C |
|||||
Viscosity |
: no data |
|||||
Oxide |
Ti |
Ts-Ti9 |
Melting point |
: < -20°C |
|
|
Vapor pressure |
: 0.1Torr (@59°C) |
|||||
Decomp. Temp. |
: 340°C |
|||||
Viscosity |
: no data |
|||||
Ta |
Ts-Ta7 |
Melting point |
: 11°C |
|
||
Vapor pressure |
: 0.1Torr (@46°C) |
|||||
Decomp. Temp. |
: 240°C |
|||||
Viscosity |
: no data |
|||||
Nb |
Ts-Nb10 |
Melting point |
: 20°C |
|
||
Vapor pressure |
: 0.1Torr (@50°C) |
|||||
Decomp. Temp. |
: 260°C |
|||||
Viscosity |
: no data |
|||||
Hf |
Ts-Hf3 |
Melting point |
: < -20°C |
|
||
Vapor pressure |
: 0.1Torr (@77°C) |
|||||
Decomp. Temp. |
: 236°C |
|||||
Viscosity |
: no data |
|||||
Zr |
Ts-Zr2 |
Melting point |
: < -20°C |
|
||
Vapor pressure |
: 0.1Torr (@68°C) |
|||||
Decomp. Temp. |
: 242°C |
|||||
Viscosity |
: no data |
|||||
Bi |
Ts-Bi6 |
Melting point |
: < -20°C |
|
||
Vapor pressure |
: 0.1Torr (@55°C) |
|||||
Decomp. Temp. |
: 230°C |
|||||
Viscosity |
: 7cP (@25°C) |
|||||
Al |
Ts-Al4 |
Melting point |
: < -15°C |
|
||
Vapor pressure |
: 0.1Torr (@44°C) |
|||||
Decomp. Temp. |
: 328°C |
|||||
Viscosity |
: no data |
|||||
Si |
SiTBAS® |
Melting point |
: liquid at rt |
|
||
Vapor pressure |
: 0.1Torr (@28°C) |
|||||
Decomp. Temp. |
: 320°C |
|||||
Viscosity |
: no data |
|||||
Nitride |
Si |
SiTBIS® |
Melting point |
: < -20°C |
|
|
Vapor pressure |
: 0.1Torr (@34°C) |
|||||
Decomp. Temp. |
: 300°C |
|||||
Viscosity |
: no data |
|||||
PECVD |
Low-k |
SiOCH |
TD-50 |
Melting point |
: < -20°C |
|
Vapor pressure |
: 1Torr (@86°C) |
|||||
Decomp. Temp. |
: 237°C |
|||||
Viscosity |
: no data |
|||||
GasBarrier |
SiO2 |
TG-4E |
Flash point |
: 53°C |
|
|
Vapor pressure |
: 100Torr (@124°C) |
|||||
Decomp. Temp. |
: 290°C |
|||||
Viscosity |
: no data |
|||||
If you are interested in our chemical precursors, please contact us through the contact form below for more information:
